产品中心
详细信息
三光机s350;针对半导体先进封装晶圆切割前后Die表面缺陷、切割道缺陷及RDL缺陷检测
业内的 AI 2.0 检测算法软件简单易用,集成自动编程功能
设备可检测碰线、塌丝、甩丝、断丝、漏焊、重焊、焊线高度、线线距离、沾污、划伤、异物、偏移、转角、翘片、有无、贴错芯片、崩边、崩角、多胶、少胶、爬胶高度……
晶圆表面脏污,残胶,划痕,切割道缺陷以及RDL缺陷检测
- 支持明场、暗场、Photolumination、透射多种照明方式
- 业内的 AI 2.0 检测算法
整面晶圆 Bump 高度及共面性量测
- 高速、的 Bump 高度量测系统
三光检验方法在电子芯片质量控制中扮演着至关重要的角色。通过这种检验方法,生产商可以在早期阶段发现并解决潜在的质量问题,从而提高产品的良率和可靠性。同时,这也有助于减少因芯片质量问题而导致的设备故障和性能下降,保障消费者的利益。
总之,三光检验方法是电子芯片生产过程中不可或缺的一环。通过严格执行这一检验流程,我们可以确保电子芯片的质量和性能达到行业标准,为现代电子设备的稳定运行提供有力保障。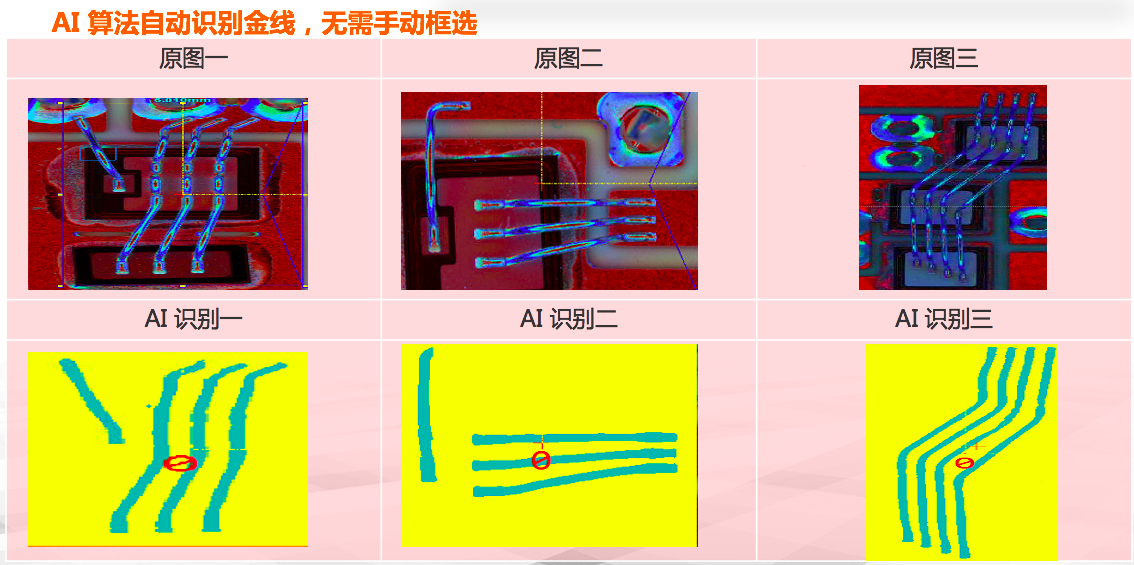
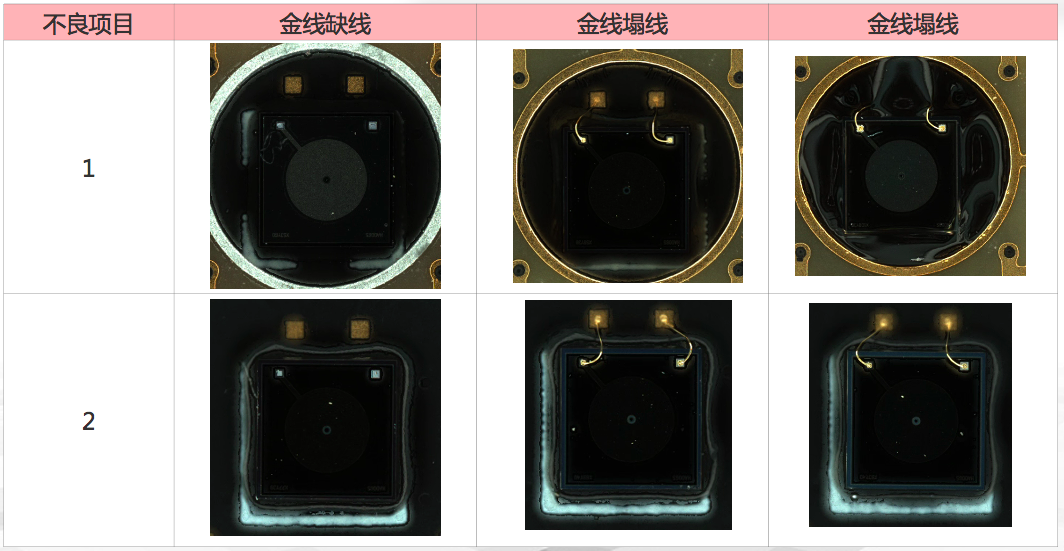
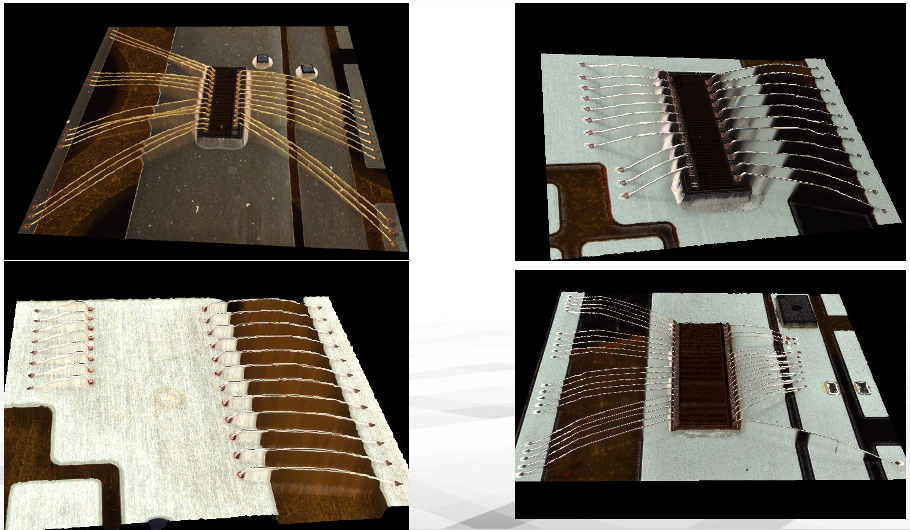
设备规格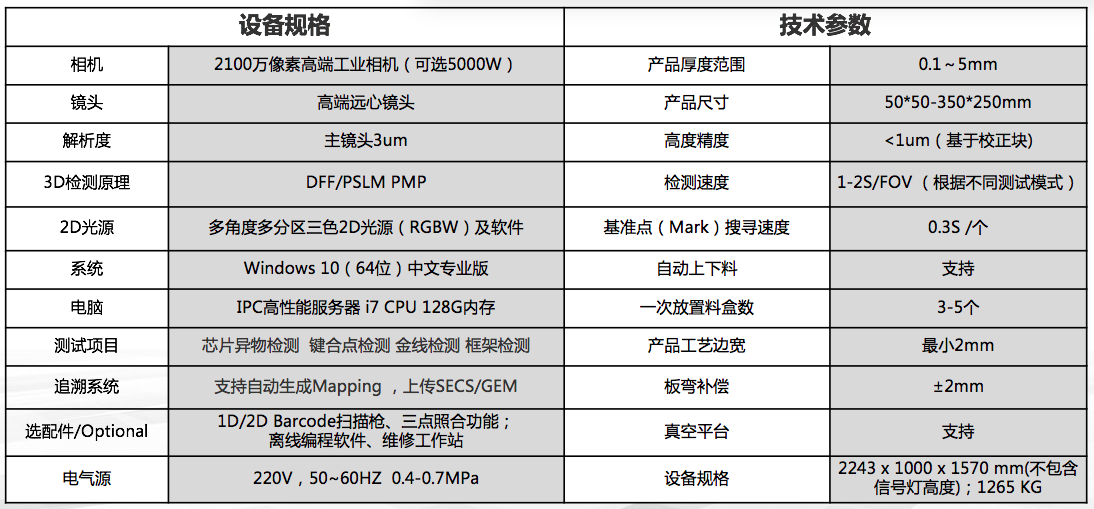

 收藏该店铺
收藏该店铺 已收藏
已收藏